
熱門搜索:
代理日本品牌:OTSUKA大塚電子(薄膜測厚儀、相位差膜設(shè)備等)、USHIO牛尾點光源、CCS檢查光源、Aitec艾泰克、REVOX萊寶克斯、ONOSOKKI小野測器、YAMATO雅馬拓、KOSAKA小坂臺階儀、SEN特殊光源、TSUBOSAKA壺坂電機(jī)、NEWKON新光、TOKISANGYO東機(jī)產(chǎn)業(yè)、tokyokeiso東京計裝、leimac雷馬克、MIKASA米卡薩勻膠機(jī)、COSMO科斯莫、SAKURAI櫻井無塵紙、TOE東京光電子、EYE巖崎UV燈管、SANKO山高、HOYA豪雅光源、日本IMV愛睦威地震儀、HOKUYO北陽電機(jī)、SAKAGUCHI坂口電熱、ThreeBond三鍵膠水等.

產(chǎn)品中心
-
Stucchi思多奇
-
NITTO KOHKI日...
-
Sankei
-
KYOWA協(xié)和工業(yè)
- DIT東日技研
- AITEC艾泰克
-
SIGMAKOKI西格瑪...
- REVOX萊寶克斯
- CCS 希希愛視
- SIMCO思美高
- POLARI0N普拉瑞
- HOKUYO北陽電機(jī)
- SSD西西蒂
- EMIC 愛美克
- TOFCO東富科
-
打印機(jī)
- HORIBA崛場
- OTSUKA大冢電子
- MITAKA三鷹
- EYE巖崎
- KOSAKA小坂
-
SAGADEN嵯峨電機(jī)
- TOKYO KEISO東...
- takikawa 日本瀧...
- Yamato雅馬拓
- sanko三高
- SEN特殊光源
-
SENSEZ 靜雄傳感器
- marktec碼科泰克
- KYOWA共和
- FUJICON富士
- SANKO山高
-
Sugiyama杉山電機(jī)
-
Osakavacuum大...
-
YAMARI 山里三洋
- ACE大流量計
- KEM京都電子
- imao今尾
- AND艾安得
- EYELA東京理化
- ANRITSU安立計器
- JIKCO 吉高
- NiKon 尼康
- DNK科研
- Nordson諾信
- PISCO匹斯克
- NS精密科學(xué)
- NDK 日本電色
-
山里YAMARI
- SND日新
-
Otsuka大塚電子
- kotohira琴平工業(yè)
- YAMABISHI山菱
- OMRON歐姆龍
- SAKURAI櫻井
- UNILAM優(yōu)尼光
-
氙氣閃光燈
-
UV反轉(zhuǎn)曝光系統(tǒng)
-
UV的水處理
-
檢測系統(tǒng)
-
光照射裝置
-
點光源曝光
-
變壓型電源供應(yīng)器
-
超高壓短弧汞燈
-
UV光洗凈
-
UV曝光裝置
-
uv固化裝置
-
紫外可見光光度計
產(chǎn)品詳情
簡單介紹:
代理Otsuka大塚電子橢圓偏振光測量儀FE-300 多功能橢偏儀 橢偏儀系統(tǒng) 橢圓偏振光測量儀
詳情介紹:
產(chǎn)品信息
特點
- 支持從薄膜到厚膜的廣泛薄膜厚度
- 使用反射光譜進(jìn)行薄膜厚度分析
- 緊湊、低成本、非接觸式、無損、高精度測量
- 易于設(shè)置條件和測量操作! 任何人都可以輕松測量薄膜厚度
- 通過峰值巴雷法、頻率分析法、非線性*小二乘法、優(yōu)化法等多種膜厚度測量
- 非線性*小二乘法的厚度分析算法允許光學(xué)常數(shù)分析(n:折射率、k:消光計數(shù))
測量項目
- **反射率測量
- 薄膜厚度分析(10層)
- 光學(xué)常數(shù)分析(n:折射率,k:消光計數(shù))
測量對象
-
功能膜、塑料
透明導(dǎo)電膜(ITO、銀納米線)、緩速膜、偏振膜、AR膜、PET、PEN、TAC、PP、PC、PE、PVA、粘合劑、粘合劑、保護(hù)膜、硬涂層、防指紋劑等。 -
半導(dǎo)體
化合物半導(dǎo)體、Si、氧化膜、氮化膜、Resist、SiC、GaAs、GaN、InP、InGaAs、SOI、Sapphire 等。 -
表面處理
DLC 涂層、防銹劑、防霧劑等 -
光學(xué)材料
過濾器、AR 涂層等 -
FPD
LCD(CF、ITO、LC、PI)、OLED(有機(jī)膜、密封劑)等 -
其他
硬盤、磁帶、建筑材料等
原則
測量原理
Otsuka 電子采用光干涉法和內(nèi)部制造的高精度分光光度計,可實現(xiàn)非接觸式、無損和高速高精度薄膜厚度測量。 光干涉法是一種利用光學(xué)系統(tǒng)獲得的反射率來確定光學(xué)厚度的方法,如圖2所示。該光學(xué)系統(tǒng)使用光譜光度計獲得光學(xué)厚度。 以涂覆在金屬基板上的膜為例,從目標(biāo)樣品上方入射的光在膜表面反射(R1)。 此外,通過薄膜(R2)的光在基板(金屬)或膜界面反射。 測量由光路差引起的相位偏移引起的光干涉現(xiàn)象,并從獲得的反射光譜和折射率計算薄膜厚度的方法稱為光干涉法。 有四種分析方法:峰巴雷法、頻率分析法、非線性*小二乘法和優(yōu)化法。
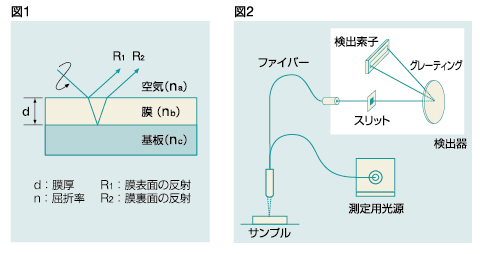
規(guī)格
手勢
| 測量波長范圍 | 300~800nm | |
|
測量膜厚度范圍 (SiO2轉(zhuǎn)換) |
3nm~35μm | |
| 點直徑 | φ1.2mm | |
| 樣本大小 | φ200×5(H)mm | |
| 測量時間 | 0.1~10s以內(nèi) | |
| 電源 | AC100V±10% 300VA | |
| 尺寸、重量 | 280(W)×570(D)×350(H)mm、24kg | |
| 其他 | 參考板,食譜創(chuàng)建服務(wù) | |
軟件屏幕

塔瑪薩崎電子(蘇州)有限公司代理、直營各日本品牌工業(yè)產(chǎn)品,聯(lián)系人:張小姐
聯(lián)系電話:15902189399
江蘇地區(qū)代理Otsuka大塚電子橢圓偏振光測量儀FE-300
上海地區(qū)代理Otsuka大塚電子橢圓偏振光測量儀FE-300
浙江地區(qū)代理Otsuka大塚電子橢圓偏振光測量儀FE-300
產(chǎn)品留言
標(biāo)題
聯(lián)系人
聯(lián)系電話
內(nèi)容
注:1.可以使用快捷鍵Alt+S或Ctrl+Enter發(fā)送信息!
2.如有必要,請您留下您的詳細(xì)聯(lián)系方式!
2.如有必要,請您留下您的詳細(xì)聯(lián)系方式!
